前回は、ディウェッティングをめっきの観点から考えてみました。
今回は、電子部品のめっき金属膜におけるディウェッティング現象と要因、制御について触れてみたいと思います。
ディウェッティングを制御・抑制するための方策としては、いくつかの基本原則が知られています。
膜厚をある臨界値以上に確保すること、結晶粒を粗大化させ粒界密度を低減すること、基板との界面エネルギーを低下させる中間層を導入すること、さらには不純物や残留応力を低減するめっきプロセス設計などが挙げられます。
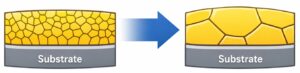
特にめっき被膜では、前処理の最適化や後熱処理条件の制御によって、ディウェッティング感受性を大きく変えることが可能です。
総括すると、ディウェッティングは金属薄膜およびめっき被膜に普遍的に存在する、熱力学と拡散現象に基づく形態不安定化現象です。
その発現は材料物性、膜構造、界面状態、使用環境に強く依存し、工業製品の信頼性と直結しています。
一方で、その機構を正しく理解し制御することで、新たな機能創出にもつながる可能性を秘めています。
電子部品用途で頻繁に用いられるAu、Ag、Niなどのめっき系金属に焦点を当て、実際の工程・使用環境で問題となりやすいことについて考えてみます。
実務上の主な原因・要因としては、第一に膜厚不足が挙げられます。数十ナノメートル以下の金属膜では、初期の厚さ揺らぎや欠陥が拡散によって増幅されやすく、比較的低温でも膜の分断が進行します。
第二に結晶粒構造であり、微細粒・高粒界密度の被膜では粒界拡散が支配的となり、ディウェッティング開始温度が低下します。
第三に界面要因として、下地金属との濡れ性不良、酸化膜残存、不均一な前処理状態が挙げられます。
第四にめっき特有の要因として、内部応力、共析不純物、水素、添加剤残渣などの非平衡要素が存在します。
これらの原因が組み合わさることで現れる現象が、連続膜の不安定化および島状化になるのです。
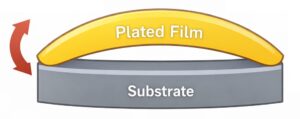
初期段階では、表面あるいは界面に微小な凹凸や局所的な薄膜領域が形成され、加熱や通電、長時間放置によりそれらが成長します。
次の段階ではピンホールや孔が拡大し、隣接する孔同士が連結することで膜が分断されます。
最終的には孤立した島状粒子あるいはネットワーク状構造となり、電気的・機械的・光学的特性が大きく変化します。
電子部品用途では、この現象は具体的な不具合として観測されます。
電気接点では導電経路の不連続化による接触抵抗上昇やばらつき増大が生じ、ワイヤボンディングやはんだ接合部では濡れ性低下や信頼性劣化につながります。
電極用途では、表面粗化や島状化により設計通りの電界分布が得られなくなる。

これらは多くの場合、外観検査では初期に検出されにくく、加速試験や長期使用後に顕在化する点が実務上の課題となっています。
次回は、Au・Ag・Niめっき被膜におけるディウェッティング特性とその対策について触れてみたいと思います。

































































































 お問い合わせはこちら
お問い合わせはこちら
 FlabR(フラバー)について
FlabR(フラバー)について